Musisz być zalogowany/a
Zyskiwanie Prędkości: Moduły Mocy Mitsubishi Electric SiC

Zyskiwanie Prędkości: Moduły Mocy Mitsubishi Electric SiC
W wydaniu "Bodo’s Power System" we wrześniu 2017 roku opublikowaliśmy przegląd historii i statusu naszych modułów mocy SiC, obejmujących szeroki zakres dostępnych komercyjnie modułów SiC, od kilkudziesięciu amperów do 1200 A i napięć znamionowych od 600V do 3300V [1]. Dziś, rok później, technologia SiC nabrała jeszcze większej prędkości. Niniejszy artykuł prezentuje najnowsze osiągnięcia Mitsubishi Electric w zakresie modułów mocy SiC pod względem badań, rozwoju produktów i zastosowań. Szczególny nacisk w tym artykule położono na moduły SiC o wysokim napięciu.
Autorzy: Junji Yamada, Mitsubishi Electric, Power Device Works, Fukuoka, Japonia oraz Eckhard Thal, Mitsubishi Electric Europe, Ratingen, Niemcy
Badania nad SiC w Japonii
Aktywności badawcze na temat SiC są koordynowane w Japonii przez organizację o nazwie NEDO (New Energy and Industrial Development Organization). NEDO to największa japońska publiczna organizacja zarządzająca badaniami i rozwojem, koordynująca wysiłki innowacyjne w strategicznych kierunkach. Rozwój modułów mocy SiC o wysokiej gęstości i wysokim napięciu izolacyjnym jest jednym z głównych kierunków badań i rozwoju NEDO, a Mitsubishi Electric jest kluczowym graczem w tej dziedzinie [2]. Wiele znaczących wyników badań Mitsubishi Electric nad technologią SiC, o których mowa w tym artykule, uzyskano dzięki wsparciu NEDO.
Osadzenie diody Schottky'ego (SBD) w SiC-MOSFET
Idea osadzenia SBD bezpośrednio w czipie MOSFET jest pokazana na Rysunku 1 [3].
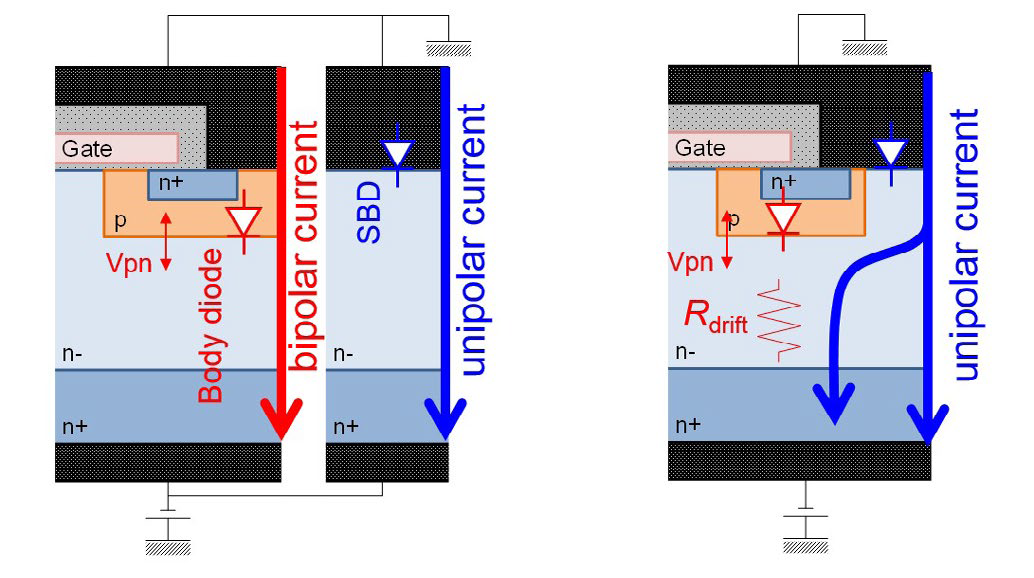
Rysunek 1: Przekrój (a) konwencjonalnego SiC-MOSFET z zewnętrznym SBD i (b) SiC-MOSFET z osadzoną diodą SBD
Jako że praca diody ciała może powodować degradację bipolarną poprzez rozszerzanie się w SiC-MOSFET, zaleca się jej unikanie. Obie struktury pokazane na Rysunku 1 osiągają ten cel tym samym zasadą: dopóki napięcie przewodzenia SBD jest niższe niż wbudowany potencjał Vpn diody ciała MOSFET, nie będzie przepływać prąd przez bipolarną diodę ciała. Wiele dostępnych dziś modułów SiC [1] korzysta z podejścia (a). Wyniki badań przedstawione w [3] pokazują, że poprzez integrację SBD do czipu MOSFET (b) warunek "brak przepływu prądu przez bipolarną diodę ciała" można osiągnąć dla znacznie wyższych gęstości prądu SBD niż w konwencjonalnej strukturze (a) z antyrównoległym SBD. W efekcie, aktywna powierzchnia czipa potrzebna do utworzenia funkcjonalnego przełącznika (MOSFET + antyrównoległa dioda) może być drastycznie zmniejszona dzięki użyciu podejścia (b).
![Aktywny obszar 3.3kV i 6.5kV konwencjonalnego SiC-MOSFET z zewnętrznym SBD w porównaniu z SiC-MOSFET z osadzoną diodą SBD [4]](https://www.dacpol.eu/img/cms/Baza%20Wiedzy/Mitsubishi/21/Figure2.png)
Rysunek 2: Aktywny obszar 3.3kV i 6.5kV konwencjonalnego SiC-MOSFET z zewnętrznym SBD w porównaniu z SiC-MOSFET z osadzoną diodą SBD [4]
![Specyficzne rezystancje włączania rozdzielone na rezystancję kanału (czerwony), rezystancję przepływu (zielony) i rezystancję rozproszenia (niebieski) w SiC-MOSFET 3.3kV i 6.5kV z osadzoną diodą SBD przy Tj=150°C w porównaniu do tych w konwencjonalnych SiC-MOSFET [4]](https://www.dacpol.eu/img/cms/Baza%20Wiedzy/Mitsubishi/21/Figure3.png)
Rysunek 3: Specyficzne rezystancje włączania rozdzielone na rezystancję kanału (czerwony), rezystancję przepływu (zielony) i rezystancję rozproszenia (niebieski) w SiC-MOSFET 3.3kV i 6.5kV z osadzoną diodą SBD przy Tj=150°C w porównaniu do tych w konwencjonalnych SiC-MOSFET [4]
W [4] badany jest wpływ osadzenia diody Schottky'ego w SiC-MOSFET na SiC-MOSFET 3.3kV i 6.5kV. Wskaźnik redukcji aktywnej powierzchni czipa wynosi 50% dla modułów SiC o napięciu 3.3kV i 75% (!) dla modułów o napięciu 6.5kV, jak pokazano na Rysunku 2. Ten przykład pokazuje, że podejście (b) jest atrakcyjne szczególnie dla SiC-MOSFET o bardzo wysokim napięciu. Z drugiej strony, wpływ integracji SBD do czipu MOSFET na zwiększenie (pogorszenie) specyficznej rezystancji włączania jest niewielki, jak pokazano na Rysunku 3. Charakterystyki w przekazie nowych próbek SiC-MOSFET z osadzoną diodą SBD przedstawiono na Rysunku 4.
![Charakterystyki odprowadzania próbek 3.3kV i 6.5kV w temperaturze pokojowej i Tj=150°C [4]](https://www.dacpol.eu/img/cms/Baza%20Wiedzy/Mitsubishi/21/Figure4.png)
Rysunek 4: Charakterystyki odprowadzania próbek 3.3kV i 6.5kV w temperaturze pokojowej i Tj=150°C [4]
Nowy dwułomowy moduł SiC o napięciu 6.5kV
Opierając się na nowych SiC-MOSFETach o napięciu 6.5kV z osadzoną diodą SBD, Centrum Zaawansowanych Technologii Mitsubishi Electric ogłosiło w styczniu 2018 roku [5] moduł mocy Full-SiC o najwyższej na świecie gęstości mocy, wynoszącej 9.3kVA/cm³, jak pokazano na Rysunku 5. Porównując tę gęstość mocy z 5.1kVA/cm³ oferowaną przez najlepszy na świecie konwencjonalny moduł Si-Power o napięciu 6.5kV, wyraźnie widać ogromny potencjał redukcji rozmiaru systemu.

Rysunek 5: Prototyp 6,5kV modułu mocy z półprzewodnikami typu Full-SiC
Wydajność nowego podwójnego modułu Full-SiC o napięciu 6,5kV została zbadana w [6] pod różnymi aspektami. Na podstawie niedawno opracowanego nowego standardowego podwójnego opakowania HV100 [7], struktura wewnętrznego modułu została zoptymalizowana za pomocą symulacji elektromagnetycznych w trójwymiarze w celu zmniejszenia indukcyjności wewnętrznego opakowania, osiągnięcia dobrego dynamicznego podziału prądu między zrównoleglonymi układami SiC-MOSFET i poprawy odporności na zakłócenia elektromagnetyczne (EMI). Szczególną uwagę zwrócono na wyeliminowanie zakłóceń magnetycznych w kierunku bramki, spowodowanych wysoką prędkością przełączania. Zsymulowane fale przełączania w fazie włączania przed i po optymalizacji są pokazane na Rysunku 6. Zmierzone fale przełączania przy temperaturze pokojowej oraz Tj=175°C na Rysunku 7 pokazują, że prędkość przełączania po stronie P i N jest prawie taka sama. Ponadto nie można zaobserwować istotnych różnic w wydajności przełączania między temperaturą pokojową a Tj=175°C, co wskazuje na to, że wydajność urządzenia jest unipolarna.

Rysunek 6: Symulowane fale przełączania w fazie włączania przed i po optymalizacji
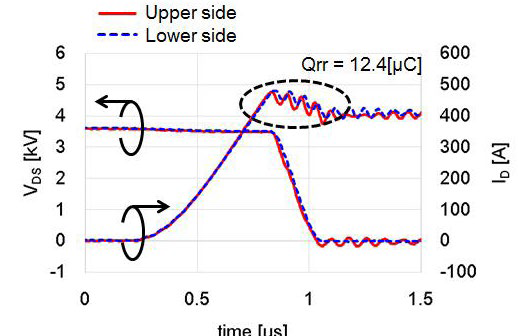
(a) Fala włączania przy 25°C
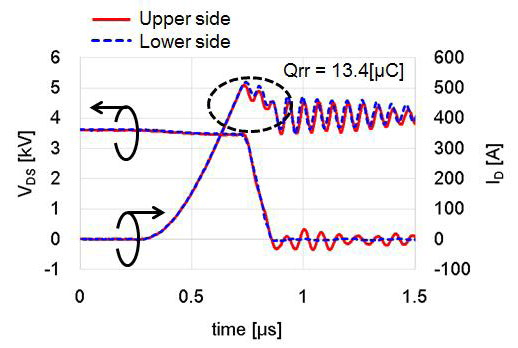
(b) Fala włączania przy 175°C
Rysunek 7: Porównanie fal włączania po stronie P i N przy (a) temperaturze pokojowej i (b) Tj=175°C
Całkowita energia przełączania nowego modułu 6,5kV Full-SiCMOSFET z wbudowanymi diodami Schottky'ego (SBD) jest mniejsza o mniej niż 10% w porównaniu z konwencjonalnymi modułami Si-IGBT o napięciu 6,5kV, jak pokazano na Rysunku 8.
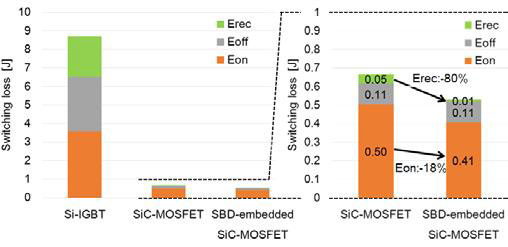
Rysunek 8: Porównanie strat przełączania między Si-IGBT przy Tj150°C, SiC-MOSFET a SBD-embedded SiCMOSFET przy 175°C
Ta drastyczna redukcja strat przełączania otwiera drogę do zastosowań modułów mocy o wysokim napięciu przy częstotliwości przełączania w zakresie kilku kHz, gdzie dzisiejsze moduły Si-HVIGBT o napięciu 6,5kV okazały się niewłaściwe, nawet gdy są używane w trybie rezonansowym (na przykład w zastosowaniach transformatora półprzewodnikowego). Jako odniesienie, w [6] przedstawiona jest symulacja strat mocy pokazana na Rysunku 9 dla częstotliwości 500Hz, 2kHz i 10kHz.
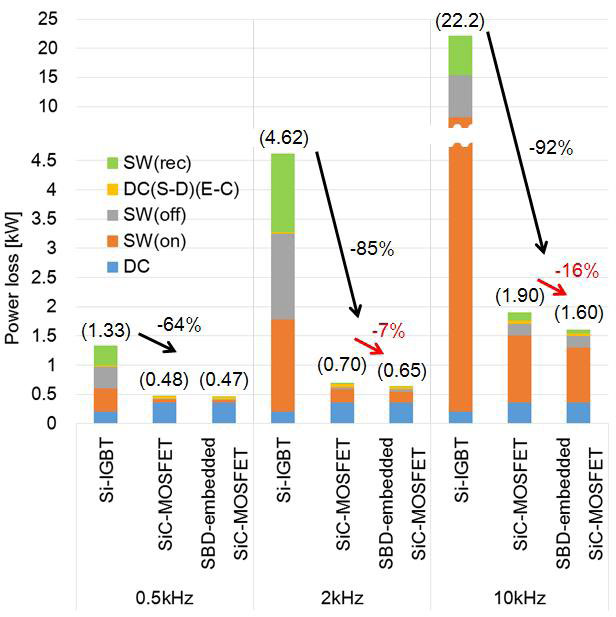
Rysunek 9: Porównanie strat mocy między Si-IGBT przy Tj150°C, SiCMOSFET a SBD-embedded SiC-MOSFET przy Tj=175°C
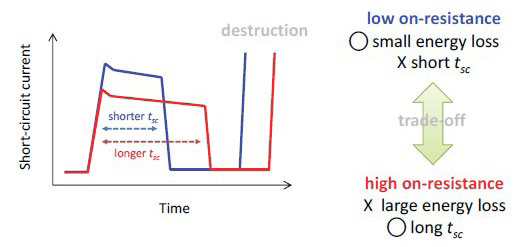
Rysunek 10: Zależność między rezystancją włączenia a czasem zwarcia tsc
Poprawa zdolności do krótkotrwałego zwarcia SiC-MOSFET
Jednym z problemów dzisiejszych SiC-MOSFET-ów jest ograniczona wytrzymałość na krótkotrwałe zwarcia. Jednym ze sposobów zwiększenia dopuszczalnego czasu krótkotrwałego zwarcia tsc byłoby zwiększenie rezystancji włączenia SiC-MOSFET. Jednak podejście to prowadziłoby do dużych strat energii w stanie włączonym. Zasada związku między rezystancją włączenia a czasem krótkotrwałego zwarcia tsc jest wyjaśniona na Rysunku 10.
W [8] i [9] Mitsubishi Electric ogłosiła nową własną strukturę układu, która obecnie znajduje się w fazie badawczej i rozwojowej, aby poradzić sobie z tym problemem: poprzez wprowadzenie dodatkowego obszaru do obszaru źródła, patrz Rysunek 11. W ten sposób kontrolowana jest rezystancja szeregowa źródła SiC-MOSFET i zmniejszane jest występowanie nadmiernego przepływu prądu podczas działania w krótkotrwałym zwarcie.
![Przekrój nowo opracowanego SiC-MOSFET [9]](https://www.dacpol.eu/img/cms/Baza%20Wiedzy/Mitsubishi/21/Figure11.png)
Rysunek 11: Przekrój nowo opracowanego SiC-MOSFET [9]
W ten sposób osiągnięto czas zwarcia tsc=8µs (podobny do dzisiejszego Si-IGBT) bez znacznego zwiększenia rezystancji włączenia. Zgodnie z komunikatem prasowym Mitsubishi Electric z września 2017 roku, nowe urządzenie SiC oferuje najwyższą na świecie wydajność mocy spośród urządzeń mocy klasy 1200V z czasem zwarcia przekraczającym 8µs [9]. Na Rysunku 12 porównano rezystancję włączenia a czas zwarcia nowego SiC-MOSFET z konwencjonalnym SiC-MOSFET. Przy tsc=8µs, rezystancja włączenia została zmniejszona o 40% w porównaniu z konwencjonalnym SiC-MOSFET.
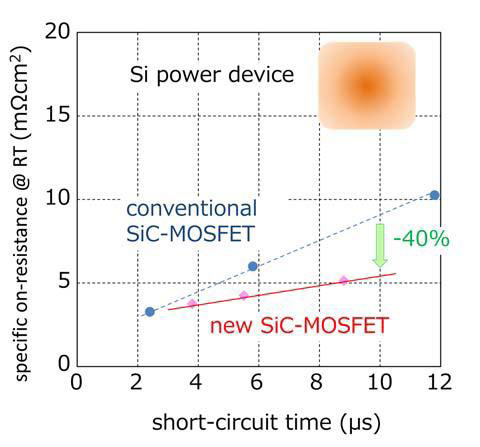
Rysunek 12: Rezystancja włączenia przy temperaturze pokojowej w zależności od czasu zwarcia
Symulacja zachowania SiC-MOSFET podczas przełączania
Dokładna symulacja przejściowego zachowania, na przykład nachylenia napięcia dren-źródło dvDS/dt i nachylenia prądu drenowego diD/ dt, jest ważna dla optymalizacji wewnętrznej struktury modułów SiC-MOSFET. W [10] opisano nowy model zachowania SiC-MOSFET uwzględniający wewnętrzne indukcyjności i pojemności rozproszone. Dzięki użyciu tego modelu możliwe było dokładne odtworzenie działania zrównoleglonych SiC-MOSFET nawet w warunkach termicznie niezrównoważonych [11]. W [12] ten model został dalej udoskonalony. Widoczne na Rysunku 13 fale wskazują na dobrą zgodność wyników symulacji z wynikami eksperymentalnymi. Nowy model SiC-MOSFET jest potężnym narzędziem do projektowania obwodów elektronicznych z wykorzystaniem symulacji [12].

Rysunek 13: Porównanie wyników symulacji z wynikami eksperymentalnymi fali przełączania SiC-MOSFET 15A/1200V podczas (a) włączania i (b) wyłączania
Nowy dwustronny moduł Full SiC o mocy 750A/3300V
Moduł dwustronny Full-SiC o mocy 750A/3300V firmy Mitsubishi Electric został ogłoszony na konferencji PCIM-Europe 2017 [13]. Obecnie urządzenie to jest dostępne komercyjnie; nosi nazwę FMF750DC-66A. W celu minimalizacji indukcyjności wewnętrznych opakowania i zapewnienia dobrego równoważenia prądu między zrównoleglonymi układami, zastosowano najbardziej zaawansowane podwójne opakowanie dla tej klasy napięciowej i mocy, nowe opakowanie LV100, patrz Rysunek 14.

Rysunek 14: Zarys opakowania FMF750DC-66A
Dwie główne opcje poprawy wydajności systemu z wykorzystaniem FMF750DC-66A w porównaniu z konwencjonalnymi modułami HVIGBT to [14]:
- Zwiększenie częstotliwości przełączania, utrzymując poziom strat mocy taki sam jak w przypadku dzisiejszych Si-IGBT (dla tego samego systemu chłodzenia). Ta kierunek jest interesujący ze względu na uzyskanie korzyści systemowych, które nie były osiągalne w przypadku dzisiejszych modułów Si-HVIGBT z powodu ich wyższej energii przełączania Esw. Wyniki symulacji opisane w [14] wskazują, że dla tej samej wartości prądu wyjściowego inwertera częstotliwość przełączania może zostać zwiększona o współczynnik 5...7 przy użyciu modułu FMF750DC-66A zamiast jego odpowiednika Si-HVIGBT.
- Zmniejszenie strat mocy (zwiększenie sprawności systemu) w celu zmniejszenia wysiłków chłodzenia, utrzymując podobny poziom częstotliwości przełączania, jak w przypadku dzisiejszych HVIGBT, w celu:
- zwiększenia gęstości mocy systemu (zmniejszenie rozmiaru i wagi systemu);
- zwiększenia sprawności systemu w celu zwiększenia czasu pracy autonomicznych, zasilanych baterią systemów lub w celu zmniejszenia całkowitego kosztu posiadania związanego z utratą energii w systemach konwersji mocy pracujących w trybie ciągłym (np. UPS lub falowniki PV).
W zależności od wymagań aplikacji, możliwa jest także mieszanka obu potencjalnych opcji poprawy wydajności 1. i 2.
Podczas projektowania systemu elektronicznego z modułami Full-SiC pojawia się pytanie, jak poradzić sobie z ich wyższą prędkością przełączania w porównaniu z Si-IGBT, zwłaszcza wyższym dvDS/dt. W [15] zbadano wpływ temperatury, rezystancji bramki i napięcia bramkowego na wydajność przełączania nowego FMF750DC-66A. Na Rysunku 15 przedstawione są fale wyłączania dla różnych rezystorów bramki. Na Rysunku 16 pokazana jest zależność dvDS/dt od stanu bramki. Na Rysunku 17 przedstawione są krzywe zależności strat podczas wyłączania Eoff od dvDS/dt.

Rysunek 15: Przejścia napięcia podczas wyłączania dla różnych rezystorów bramkowych (VDD=1800V, ID=750A, Tj=25°C, RG(off) = 0.9…6.2Ω)
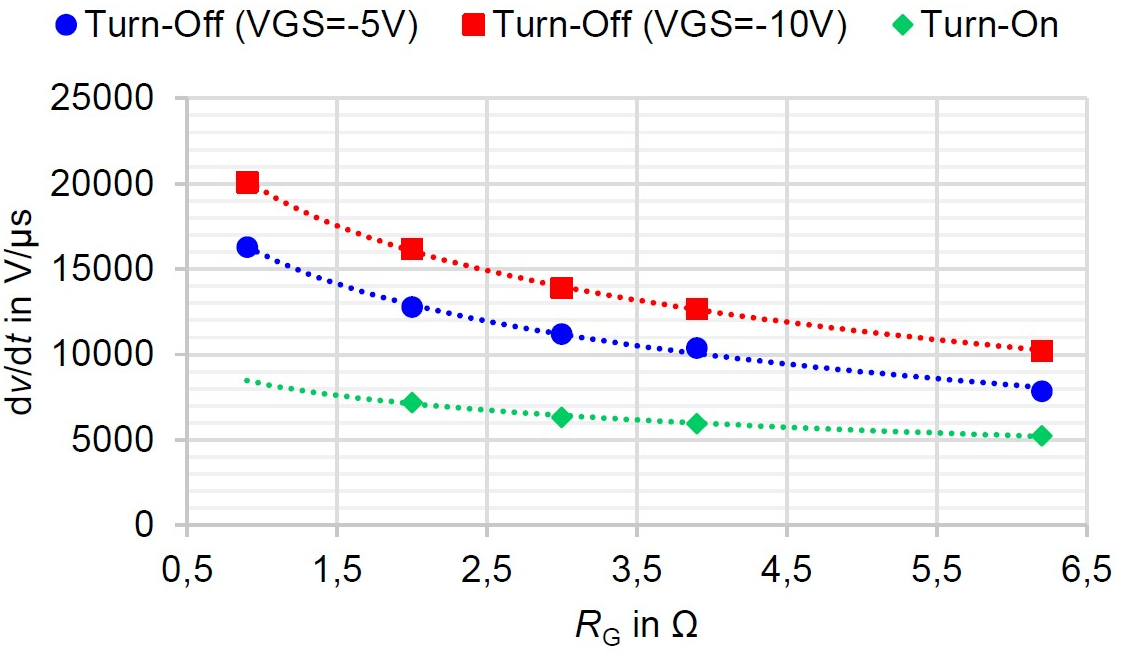
Rysunek 16: Nachylenie napięcia podczas włączania i wyłączania dla różnych rezystorów bramkowych RG i napięć bramkowych VGS (VDD=1800V, ID=750A, Tj=25°C, RG(off) = 0.9…6.2Ω)
Jako wniosek z badań doświadczalnych w [15] potwierdzono dobrą sterowność przejść napięcia FMF750DC-66A przez warunki napędu bramki.
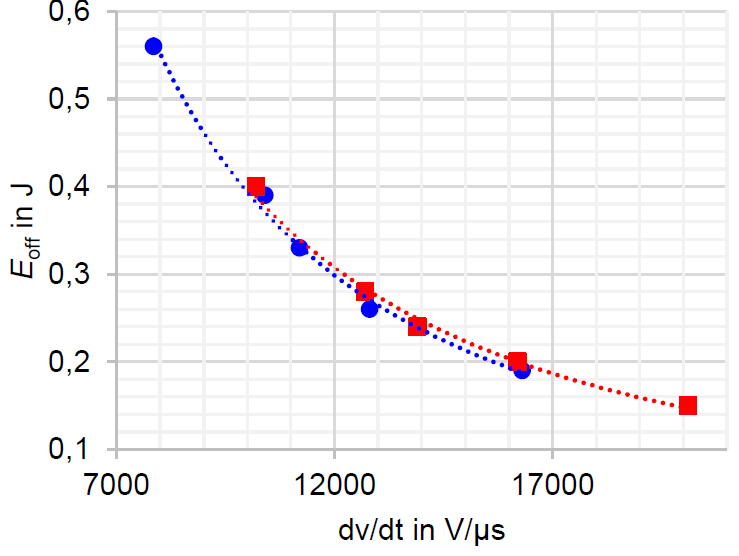
Rysunek 17: Straty podczas wyłączania FMF750DC-66A w zależności od dvDS/dt
Przykłady zastosowań modułów SiC o wysokiej mocy w Japonii
Podczas ostatniej Międzynarodowej Konferencji Elektroniki Mocy w maju 2018 roku (IPEC’18, Niigata, Japonia) zgłoszono kilka przykładów zastosowań w Japonii z wykorzystaniem modułów mocy SiC firmy Mitsubishi Electric:
Przez wykorzystanie hybrydowych modułów SiC o mocy 1200A/1700V w tramwaju o napięciu 600VDC, rozmiar przekształtnika trakcyjnego został zmniejszony o 40% w porównaniu z systemem Si-IGBT [16].
Przez wykorzystanie modułów SiC o mocy 3300V w Modularnym Konwerterze Wielopoziomowym do transmisji HVDC osiągnięto następujące wyniki [17]: redukcja strat o 50%; redukcja rozmiaru o 21% i redukcja masy o 14% w porównaniu do rozwiązania z konwencjonalnymi modułami Si-HVIGBT.
Przez wykorzystanie modułów SiC zamiast modułów IGBT w falowniku PV o mocy 750kW zgłoszono maksymalną sprawność 99%, co jest o około 0,4% lepsze niż w przypadku konwencjonalnego Si-IGBT
Podsumowanie
W ciągu ostatniego roku Mitsubishi Electric zgłosiła kilka wybitnych osiągnięć w dziedzinie technologii SiC o wysokim napięciu. Nowy dwustronny moduł FMF750DC-66A o mocy 750A/3300V został wprowadzony na rynek. Poprzez wbudowanie diody Schottky'ego antyrównoległej bezpośrednio w czip SiC-MOSFET udało się zmniejszyć aktywny obszar czipu potrzebny do modułów 6,5kV Full-SiC o 75% (!). Poprzez wykorzystanie tych nowych czipów z wbudowaną SBD zaprezentowano moduł 6,5kV Full-SiC o najwyższej na świecie gęstości mocy wynoszącej 9,3kVA/cm³. Znaczące korzyści aplikacyjne przy wykorzystaniu modułów SiC o napięciu 1700V i 3300V zgłosili liczni użytkownicy końcowi w Japonii, co wskazuje, że wprowadzenie technologii SiC nabiera tempa szczególnie w przypadku aplikacji o wysokim napięciu. Dzięki zgłaszaniu przez ostatni rok innowacji, Mitsubishi Electric udowodniła swoje przywództwo technologiczne w zakresie modułów HV-SiC.
Źródła
[1] J. Yamada, E. Thal, “SiC Power Modules for a Wide Application Range”, Bodo’s Power Systems, Sept. 2017, p.20-27
[2] S. Nomura, “NEDO’s Next-Generation Power Electronics Projects and Recent Activities”, IPEC’18, May 20-24, 2018, Niigata, Japan, Industrial Seminar, p.65-68
[3] K. Kawahara et al., “6.5kV Schottky-Barrier-Diode-Embedded SiC-MOSFET for compact Full-Unipolar Module”; ISPSD’17, May28-June1, 2017, Sapporo, Japan
[4] K. Kawahara et al., “Impact of Embedding Schottky Barrier Diodes into 3.3kV and 6.5kV SiC MOSFETs”; ICSCRM’17, September 17-22, 2017 Washington, D.C
[5] Mitsubishi Electric Press Release No.3164: “Mitsubishi Electric’s New 6.5kV Full-SiC Power Semiconductor Module Achieves World’s Highest Power Density”; Tokyo, January 31, 2018
[6] J. Nakashima et al., “6.5kV Full SiC Power Module (HV100) with SBD embedded SiC MOSFETs”; PCIM-Europe 2018, conference proceedings pp.441-447
[7] Mitsubishi Electric Press Release No.3018: “Mitsubishi Electric Develops HVIGBT Module X-Series New Dual”, Tokyo, April 6, 2016
[8] H. Hatta, “Advances in SiC power devices for power electronics applications”; IPEC’18, May 20.24, 2018 Niigata, Japan, Industrial Seminar, pp.58-64
[9] Mitsubishi Electric Press Release No.3129: “Mitsubishi Electric Develops SiC Power Device with Record Power Efficiency”, Tokyo, September 22, 2017
[10] Y. Mukunoki et al., “Modeling of a Silicon-Carbide MOSFET With Focus on Internal Stray Capacitances and Inductances, and Its Verification” IEEE Transactions on Industry Applications, Vol.54, No.3, May/June 2018, pp.2588-2597
[11] Y. Mukunoki et al., „Electro-Thermal Co-Simulation of two Parallel Connected SiC-MOSFETs under Thermally-Imbalanced Conditions”
[12] Y. Mukunoki et al., “An Improved Compact Model for a SiliconCarbide MOSFET, and its Application to Accurate Circuit Simulation”, article accepted for publication in IEEE Transactions on Industry Applications, DOI 10.1109/TPEL.2018.2796583
[13] T. Negishi et al., “3.3kV All-SiC Power Module for Traction Use”, PCIM-Europe 2017, Conference Proceedings, pp.51-56
[14] N. Soltau et al., “3.3kV Full SiC MOSFETs – Towards High Performance Traction Inverters”, Bodo’s Power Systems, January 2018, pp. 22-24
[15] N. Soltau et al., “Impact of Gate Control on the Switching Performance of a 750A/3300A Dual SiC Module”, paper at EPE2018 conference, September 17-21, 2018, Riga, Latvia
[16] S. Makishima et al., “The direct benefit of SiC Power Semiconductor Devices for Railway Vehicle Traction Inverters”, IPEC’18, May 20-24, 2018, Niigata, Japan, Conference proceedings, pp. 2047-2050
[17] Y. Ishii et al., “Verification of SiC based Modular Multilevel Cascade Converter (MMCC) for HVDC Transmission Systems”, IPEC’18, May 20-24, 2018, Niigata, Japan, Conference proceedings, pp. 1834-1839
[18] M.Kinoshita, “Power Electronics Technology Contributing to Realizing a sustainable Society”, IPEC’18, May 20.24, 2018 Niigata, Japan, Industrial Seminar, pp.53-57




Dodaj komentarz